Epoxy Flux Paste (without filler)

Application
- Reinforcement of bump edge by fillet formation after mounting of solder balls
- Stack chip package
- Package on package (Pop)
- Flip-chip semiconductor underfill
- BGA package underfill
Characteristics
- Reduces the existing flip-chip process and underfill process into a single process
- Increases productivity by reducing the number of process
- Fluxing effect the metal oxide film on package lead, solder ball, and Cu pad
- Solvent-free, cleaning-free,corrosion-free
- Customized formulation (viscosity, curing temp, Tg, etc)
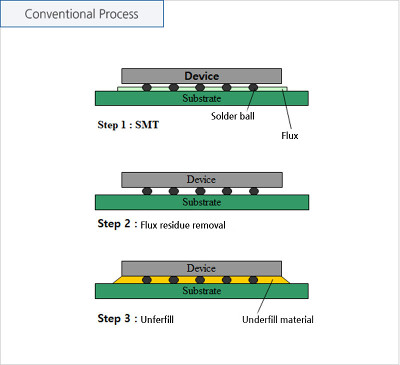

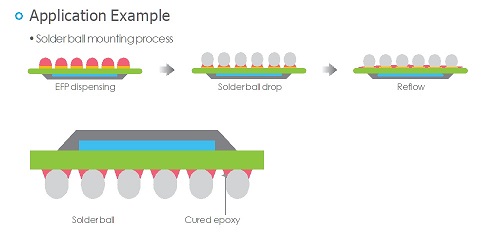
Epoxy Flux Paste (with filler)
Characteristics
- No-flow underfill material
- SiO2, filler content : 10-70 wt%
- SiO2, filler size: 0.2 - 4 um
- Customized formulation (viscosity, curing temp, curing time, Tg, etc)
Application Field
- Mounting of driver IC chips on film flip chip package
- Mounting of application processors on flip chip package
- Fine pitch I/O flip chip package